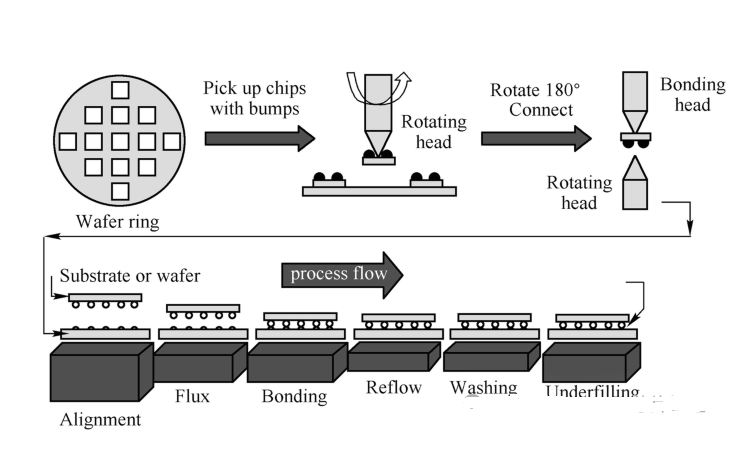
Αφήστε το ’ να συνεχίσει να μαθαίνει τη διαδικασία σχετικά με την τοποθέτηση chip.
Όπως φαίνεται στην εικόνα του εξωφύλλου.
1. Pick-up Chips with Bumps:
Σε αυτό το βήμα, η γκοφρέτα έχει κοπεί σε κύβους σε ξεχωριστά τσιπ, κολλημένη σε μπλε φιλμ ή φιλμ UV. Όταν απαιτείται η παραλαβή των τσιπ, οι καρφίτσες εκτείνονται από το κάτω μέρος, πιέζοντας απαλά το πίσω μέρος του τσιπ, ανασηκώνοντάς το ελαφρά. Ταυτόχρονα, το ακροφύσιο κενού πιάνει με ακρίβεια το τσιπ από πάνω, αποσπώντας έτσι το τσιπ από το μπλε φιλμ ή το φιλμ UV.
2. Προσανατολισμός Chip:
Αφού το τσιπ παραληφθεί από το ακροφύσιο κενού, περνά στην κεφαλή συγκόλλησης και κατά τη διάρκεια της παράδοσης, ο προσανατολισμός του τσιπ αλλάζει έτσι ώστε η πλευρά με τα εξογκώματα να βλέπει προς τα κάτω, έτοιμο να ευθυγραμμιστεί με το υπόστρωμα.
3. Στοίχιση τσιπ:
Τα εξογκώματα του περιστρεφόμενου τσιπ ευθυγραμμίζονται με ακρίβεια με τα μαξιλαράκια στο υπόστρωμα συσκευασίας. Η ακρίβεια ευθυγράμμισης είναι ζωτικής σημασίας για να διασφαλιστεί ότι κάθε εξόγκωμα ευθυγραμμίζεται με ακρίβεια με τη θέση του μαξιλαριού στο υπόστρωμα. Το Flux εφαρμόζεται στα τακάκια στο υπόστρωμα, το οποίο χρησιμεύει για τον καθαρισμό, τη μείωση της επιφανειακής τάσης στις σφαίρες συγκόλλησης και την προώθηση της ροής της συγκόλλησης.
4. Chip Bonding:
Μετά την ευθυγράμμιση, το τσιπ τοποθετείται απαλά στο υπόστρωμα από την κεφαλή συγκόλλησης, ακολουθούμενη από την εφαρμογή πίεσης, θερμοκρασίας και δόνησης υπερήχων, η οποία κάνει τις σφαίρες συγκόλλησης να καθιζάνουν στο υπόστρωμα, αλλά αυτός ο αρχικός δεσμός δεν είναι ισχυρός.
5. Reflow:
Η υψηλή θερμοκρασία της διαδικασίας συγκόλλησης επαναροής λιώνει και ρέει τις σφαίρες συγκόλλησης, δημιουργώντας μια πιο στενή φυσική επαφή μεταξύ των εξογκωμάτων του τσιπ και των μαξιλαριών του υποστρώματος. Το προφίλ θερμοκρασίας για τη συγκόλληση με επαναροή αποτελείται από στάδια προθέρμανσης, εμποτισμού, επαναροής και ψύξης. Καθώς η θερμοκρασία πέφτει, οι λιωμένες σφαίρες συγκόλλησης επαναστερεοποιούνται, ενισχύοντας σημαντικά τον δεσμό μεταξύ των σφαιρών συγκόλλησης και των μαξιλαριών υποστρώματος.
6. Πλύσιμο:
Μετά την ολοκλήρωση της επαναροής συγκόλλησης, θα υπάρχει υπολειμματική ροή που θα προσκολλάται στις επιφάνειες του τσιπ και του υποστρώματος. Επομένως, απαιτείται ένα ειδικό καθαριστικό για την αφαίρεση των υπολειμμάτων ροής.
7. Underfilling:
Εποξειδική ρητίνη ή παρόμοιο υλικό εγχέεται στο διάκενο μεταξύ του τσιπ και του υποστρώματος. Η εποξειδική ρητίνη δρα κυρίως ως ρυθμιστικό για την αποφυγή ρωγμών στα χτυπήματα λόγω υπερβολικής καταπόνησης κατά την επακόλουθη χρήση.
8. Molding:
Αφού σκληρυνθεί το υλικό εγκλεισμού στην κατάλληλη θερμοκρασία, πραγματοποιείται η διαδικασία χύτευσης, ακολουθούμενη από δοκιμή αξιοπιστίας και άλλες επιθεωρήσεις, ολοκληρώνοντας ολόκληρη τη διαδικασία ενθυλάκωσης του τσιπ.
Αυτές είναι όλες οι πληροφορίες σχετικά με το flip chip στην τεχνική SMT. Εάν θέλετε να μάθετε περισσότερα, απλώς πάρτε μια παραγγελία μαζί μας.

 Ελληνικά
Ελληνικά English
English Español
Español Português
Português русский
русский français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba